
地址:广州市南沙区市南路230号乐天云谷产业园2栋101
电话:18098907454/020-39004500
邮箱:jinkh@qualtec.com.cn

1
立碑不良现象
【关键词】立碑、贴片电阻、锡珠扩散、IMC层、模拟验证、温差
【摘要】对一立碑不良的PCBA进行了元素分析、断面观察、锡珠扩散测试等常规的检测分析后,并没有找到失效原因。通过对该PCB的gerber资料进行分析后发现贴片电阻两侧的焊盘所连接的铜面大小相差很大,使用温度模拟测试验证了两个焊盘在焊接时会产生一定的温差的可能性。
1
背景案例
1.失效样品为某型号单面贴片电路板,该PCB板经过组装后发现有贴片电阻立碑不良现象,不良率较高,并且位置固定。
2、分析方法简述
2.1外观检查
通过外观观察,发现贴片电阻一侧引脚翘起,对应的焊盘上无明显的焊锡,也没有观察到明显的助焊剂扩散现象,焊锡主要集中在电容的端电极上。
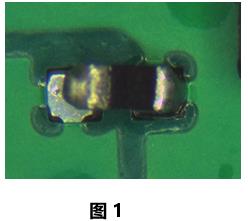
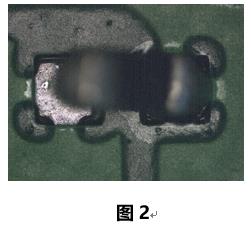
2.2 表面EDS分析
对立碑位置的焊盘表面进行EDS分析,没有检出异常的元素成分,其中PCB表面处理为化学银,锡膏为有铅锡膏。
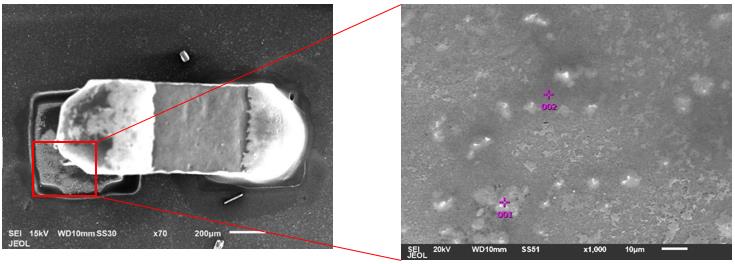


2.3 锡珠扩散测试
取相同生产同周期的未焊接的PCB板,在与立碑不良位置相同的焊盘进行表面EDS分析,未检出异常元素。


2.4 锡珠扩散测试
使用相同生产同周期的未焊接的PCB板进行锡珠润湿扩散测试,对测试后的焊锡进行直径测量,扩散直径大于2倍锡珠直径(见图3),初步确认焊盘的润湿性无异常;进行断面观察,IMC层形成良好(见图4),进一步说明焊盘的可焊性无异常
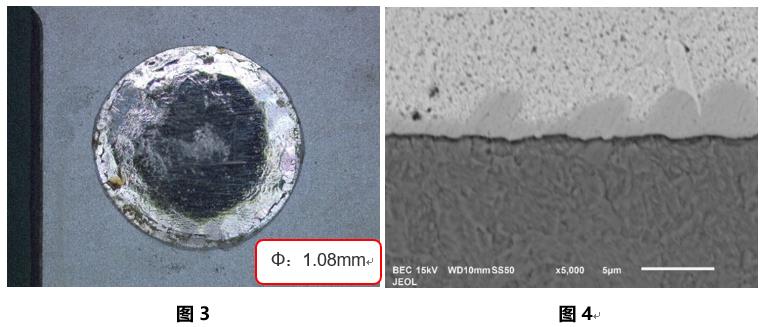
2.5立碑位置断面SEM观察
对立碑不良位置进行断面SEM观察,发现焊盘上有IMC层(见图5),对IMC层进行EDS分析,检出锡、铅元素(锡膏中主要元素),说明焊接时锡膏参与了IMC层的形成,焊盘的可焊锡无异常。
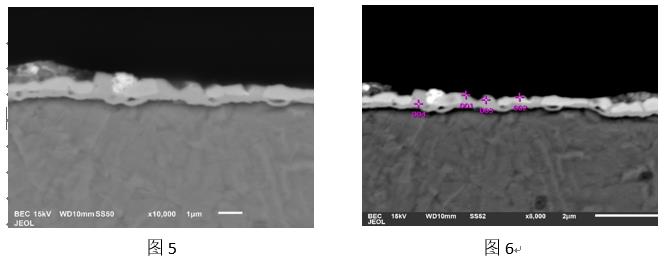

2.6温差测试(模拟验证)
对立碑不良位置的2个焊盘所在的网络进行分析,发现两个焊盘所连接的铜面相差较大,未翘起的一侧的焊盘连接的是一整块铜面,而翘起的一侧的焊盘连接的是一小块铜面,理论上在焊接时这两个焊盘会有一定的温度差。为了确认两焊盘的温度差,进行了模拟测试,发现两焊盘温度差最高达到了25.2℃。

4、结论
1.元素分析未发现有阻焊的物质,同时锡珠扩散测试结构为OK,说明PCB的可焊性无异常
2. 根据IMC层中的银、铅元素,进一步说明PCB的可焊锡是OK的,
3.使用模拟验证测试,验证了PCB焊盘铜面大小对焊接温度的影响
5、建议
1.改善优化PCB设计。
PCBA掉件不良案例分析,重点讲解PCBA失效分析过程,分析工具,分析方法,掉件不良原因润湿不良的产生原因。
>>查看详情Copyright © 2019 阔智科技(广州)有限公司 版权所有 粤ICP备19025047号-1 站点地图